Matière
- Matière et Energie
- Electronique
Les puces 3D, avenir de l'électronique
- Tweeter
-
-
1 avis :
Imaginez des puces empilées les unes sur les autres puis interconnectées entre elles, non pas par des fils, mais par des trous verticaux, percés sur toute l'épaisseur en silicium puis remplis de métal conducteur. Telle est la promesse de la technologie TSV : la réalisation de façon intégrée des puces 3D.
La technologie TSV (Through Silicon Via) suscite un grand espoir pour augmenter la densité des circuits électroniques au-delà des résultats de la loi de Moore. L’idée est de construire des circuits en 3D en superposant les puces de façon collective, tranche sur tranche. Et au lieu de fils, comme c’est aujourd’hui le cas pour les circuits 3D, les interconnexions sont intégrées directement dans le silicium sous la forme de trous enterrés, appelés TSV.
Ces trous microscopiques mesurent typiquement 10 µm de diamètre sur 80 µm de profondeur, et on tend à descendre à des dimensions de 5 µm sur 50 µm. Percés par gravure ionique sur toute l’épaisseur de silicium, ils sont ensuite remplis d’un métal conducteur – du cuivre ou du tungstène – par voie électrochimique. Chaque puce en comporte des centaines, voire des milliers. On envisage d’interconnecter ainsi jusqu’à huit puces pour réaliser des modules mémoire, ou des supercomposants combinant mémoire et processeur, capteur d’image et circuits de traitement, etc.
La réalisation des TSV nécessite une dizaine d’opérations et des équipements de gravure spécifiques comme ceux fournis par LAM Research. Cette technologie pose deux difficultés : le bon remplissage des trous pour assurer la qualité de connexion électrique et l’alignement parfait des tranches de silicium. Elle commence à être appliquée à des modules mémoires chez Samsung, Toshiba, Micron et Elpida.
Noter cet article :
Vous serez certainement intéressé par ces articles :
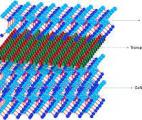
Matériaux 2D et transfert de couche mince : le CEA-Leti et Intel combinent leurs forces pour des transistors sous-nanométriques
L’Institut Leti du CEA et Intel ont annoncé, fin juin 2023, leur collaboration visant à poursuivre la miniaturisation du transistor en deçà du nanomètre. Pour remplir cet objectif d’ici à 2030, les ...

Des puces photoniques sans lithographie
Les composants photoniques alimentés par laser permettent d’envoyer et de traiter des informations à la vitesse de la lumière, offrant ainsi une solution prometteuse pour les applications ...

Un semi-conducteur superatomique plus rapide que le silicium
Les appareils électroniques tels que les ordinateurs et les téléphones portables nécessitent des semi-conducteurs pour fonctionner. Ces matériaux présentent certaines limites qui restent irrésolues ...
Recommander cet article :
- Nombre de consultations : 373
- Publié dans : Electronique
- Partager :
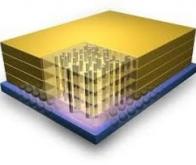
Julie
18/10/2013Bonjour,
Je souhaiterai savoir comment est réalisé le remplissage de TSV par voie électrochimique. Merci